ОЦЕНКА РАЗРЕШАЮЩЕЙ СПОСОБНОСТИ СКАНИРУЮЩЕГО ЗОНДОВОГО МИКРОСКОПА СММ2000А
Е.С. Синегубова (УГЛУ,
Екатеринбург)
И.Г. Григоров (ИХТТ
УрО РАН, Екатеринбург) grigorov@ihim.uran.ru
Estimation of the Scanning Probe
Microscopy CMM2000A instrumental resolution.
Для определения с высокой точностью шероховатости поверхности непроводящих материалов, например, выпускаемых деревообрабатывающей промышленностью, широкое применение получил метод атомно-силовой микроскопии [1].
Разрешающая способность микроскопа определяется
максимальной пространственной способностью регистрировать раздельно объекты, т.
е. минимально возможным для наблюдения расстоянием между объектами, или
максимальным увеличением, превышение которого не дает дополнительной информации
об объекте. Для сканирующей зондовой микроскопии (СЗМ) дополнительным
параметром разрешающей способности является максимальная
чувствительность к изменению высоты рельефа поверхности.
Аттестацию микроскопов обычно осуществляют с использованием специальных калибровочных приборов. Научно-исследовательский центр по изучению свойств поверхности и вакуума разрабатывает и изготавливает средства измерений для калибровки и поверки средств измерений малой длинны, которые можно использовать в качестве стандартных объектов для оценки точности воспроизведения изображения с помощью растровой электронной и сканирующей зондовой микроскопии. Например, мера периодическая специальная МПД-1,0 КС позволяет калибровать и делать поверку средств измерений малой длины в горизонтальном диапазоне 0.2 ÷ 6.0 мкм и высоту профиля ≈158 нм, а стандарт GWPS-2.0Si позволяет определять эти параметры соответственно с точностью 30 ÷ 1500 нм и 100 ÷ 1500 нм.

Рис. 1. Изображение поверхности стекла, полученное
после сканирования СММ2000А (1.6 мкм х 1.6 мкм х 10.2 нм).
Следует отметить, что приведенные выше калибровочные объекты не позволяют производить калибровку СЗМ в нано- и ангстремном диапазоне при работе в естественных условиях. Поэтому, для оценки качества полученного изображения в данных диапазонах нами, обычно, используются хорошо изученные поверхности объектов с большой вероятностью повторяемости изображения при их сканировании (например, рис. 1).
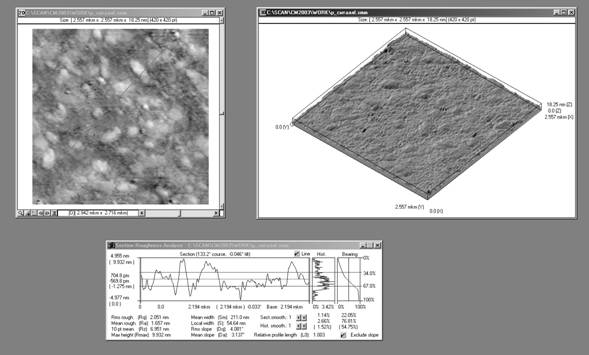
а)
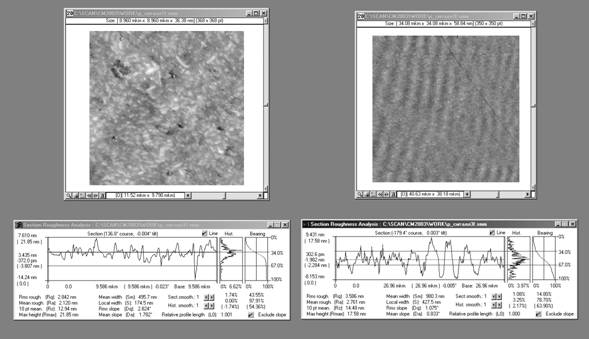
б)
Рис. 2. Поверхность
ситалла: 2.6 мкм х 2.6 мкм а), 10 мкм х 10 мкм и
34 мкм х 34 мкм б).
В данной работе методами СЗМ проведены сравнительные исследования состояния поверхности подложек из ситалла и Al2O3 (сапфир). При этом использовался сканирующий мультимикроскоп СММ-2000АТ (фирма «Протон-МИЭТ»), работающий в режиме атомно-силового микроскопа (АСМ) с контактной модой [2].

а)

б)
Рис. 3. Поверхность
сапфира 3 мкм х 3 мкм а) и 10 мкм х 10 мкм б).
На изображении поверхности ситалла при поле сканирования АСМ 2.6 мкм х 2.6 мкм с числом точек 420 х 420 (рис. 2а) разрешение точки равно приблизительно 6 нм. При этом, хорошо различимы детали размерами до 20 нм, среднеквадратичная шероховатость (Rq) выбранного профиля поверхности равна ≈ 2 нм, максимальный перепад высоты профиля Rmax ≈ 10 нм. При поле сканирования 10 мкм х 10 мкм с числом точек 368 х 368 (рис. 2б), т. е. разрешение точки уменьшено приблизительно в 4.5 раза (~ 27 нм), детали размером около 40 нм хорошо различимы, Rq ≈ 2.8 нм и Rmax ≈ 21.9 нм. При поле сканирования 34 мкм х 34 мкм с числом точек 350х350 (рис. 2б) разрешение точки ≈ 97 нм виден общий характер поверхности с чередующимися гребнями и впадинами в виде волн, а также хорошо видна царапина, Rq ≈ 3.6 нм и Rmax ≈ 17.6 нм.
Изображение поверхности сапфира размером 3 мкм х 3 мкм с точностью 494 х 494 точек (разрешение точки ≈ 6 нм) выглядит в виде дискретной упорядоченной структуры (рис. 3а) с параметрами: Rq ≈ 1 нм, Rmax ≈ 3.5 нм, период упорядоченной структуры ≈ 400 нм. При поле сканирования 10 мкм х 10 мкм (428 х 428 точек, разрешение точки ≈ 23 нм) на поверхности сапфира хорошо видны поры шириной около 230 нм (рис. 3б). Параметры поверхности Rq ≈ 1 нм и Rmax ≈ 10 нм, при чем, увеличение Rmax обусловлено за счет добавления размера глубины пор равного ≈ 7 нм.
По результатам исследования поверхностей подложек из ситалла и сапфира с величиной среднеквадратичной шероховатости в пределах 1 ÷ 2 нм можно сделать вывод, что СММ-2000А при работе в естественных атмосферных условиях позволяет получить изображения рельефа поверхности при поле сканирования 2.0 мкм х 2.0 мкм и числе точек отсчета 400 х 400, на которых хорошо видны детали размером до 10 нм, при этом точность измерения среднеквадратичной шероховатости равнялась 0.1 нм. Попытки получить с помощью данного микроскопе изображение исследуемой поверхности с большим разрешением путем уменьшения размера поля сканирования до 200 нм х 200 нм и увеличения числа точек отсчета до 500 х 500, не привели к существенному увеличению разрешающей способности, т. е. выявлению новых деталей на изображении, а наоборот ухудшили изображение за счет увеличения влияния шумовых помех.
ЛИТЕРАТУРА
- Синегубова Е.С., Григоров И.Г. Физические методы исследования структуры дисперсных и композиционных материалов на основе полимеров. // Труды I Международного евроазиатского симпозиума, УГЛТУ, 2006. Екатеринбург: ООО РИЦ «Экодрев», 2006. С. 114-115.
- Синегубова Е.С., Григоров И.Г. Исследование поверхности древесных материалов покрытых лаком, с помощью атомно-силовой микроскопии. // Труды II Международного евроазиатского симпозиума, УГЛТУ, 2007. Екатеринбург: ООО «Портофортуна», 2007. С. 48-51.